Brthrper-NP-900 负型光刻胶

应用用途
产品介绍
深圳市邦得凌触控显示技术有限公司的Brthrper-NP-900系列负型光刻胶是一种丙烯酸共聚物树脂型、近紫外线曝光的光刻胶。
分别适用于制造超厚(50-200um)和中厚(10-50um)MEMS微结构,以及普通膜(0.3-10um)的各种挖洞、字符等型貌的光刻线条;适合i、G线,X-Ray,E-beam曝光。具有好的热稳定性、抗刻蚀性、高分辨率、高深宽等特点。对近紫外350~400nm波段曝光最为敏感。即使在非常厚的光刻胶曝光情况下,曝光均匀一致,可得到具有Profile垂直侧壁和的厚膜图形。
Brthrper-NP-900系列负型光刻胶的特性
1)厚度范围,单层涂胶厚度为 0.3um to 200 um
2)50um以上厚度光刻图型高深宽比可达:10:1
3)适用于旋涂工艺涂布,比自流平式后膜光刻胶工艺制程效率更高;
4)表面平整度高,50-100um膜厚在8吋晶元面积平均膜厚误差≤5%
5)可靠性高,后烘坚膜后可作为芯片倒封装以及chiplet封装支撑胶
应用:MEMS,激光芯片,钝化层应用LED微流倒封装以及光传感器干法蚀刻制作
其中,Brthrper-NP-901A用于制作0.3-10um厚度图型:

Brthrper-NP-931A用于制作10-50um厚度图型:
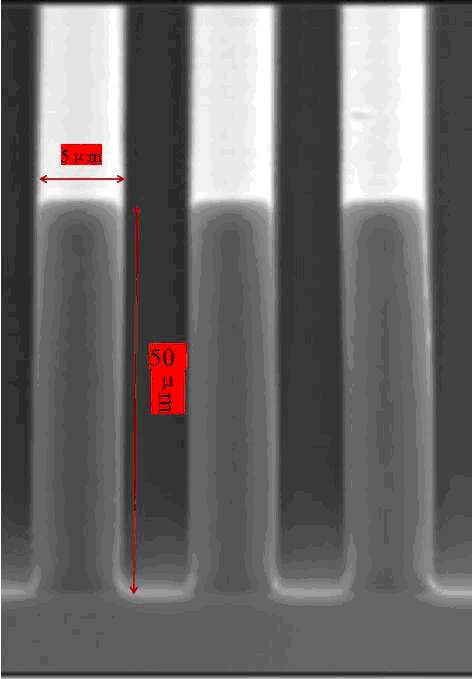
Brthrper-NP-901A光刻胶工艺参数推荐:
1.涂胶 500-1500rpm/10s
2.前烘 90℃/4min
3.曝光 150mj/cm2
4.显影 60s/27-30℃;显影液:1:99/AMPHBAL2001
5.后烘 120-200℃/30-60min
Brthrper-NP-931A光刻胶工艺参数推荐:
1.涂胶 800-3000rpm/10s
2.前烘 110℃/4min
3.曝光 200mj/cm2
4.显影 120s/27-30℃;显影液:1:99/AMPHBAL2001
5.后烘 180-230℃/30-60min
Brthrper-NP-951A光刻工艺参数推荐:
1.涂胶 3000-5000rpm/10s
2.前烘 110℃/4min
3.曝光 200mj/cm2
4.显影 150-180s/27-30℃;显影液:1:99/AMPHBAL2001
5.后烘 200-230℃/30-60min
成膜物化参数

三、包装及贮存
包装:3.8L洁净加仑桶,加不透光包装袋
贮存:密封后于0-5摄氏度保存;贮运中避免日晒、雨淋、泄露
保质期:3个月
深圳邦得凌公司于2018年11月成立,由国内最早开发触控显示领域用光阻剂的专业团队,并吸收日本特种感光高分子功能材料技术而来。
公司核心团队从事各类负型光刻胶/光阻剂(Nagtive Photo Rresist)及相应纳米复合材料开发十多年,拥有对该类材料的丰富定制化经验。并对负型类光刻胶与光刻制程之间的工艺衔接关系把握准确。
本公司除了可以为光刻器件用户提供优质的光刻胶,还是国内唯一拥有负型光刻胶用黄光树脂(Binder Polymer)量产化技术的高分子材料设计与开发团队。
此外,公司还有精细化学合成能力,已经成功开发出140余种中间体用于OLED和有机太阳能用有机半导体材料。